【摘要】 在大块绝缘材料的电子显微分析中,由于初级电子在失去动能后被捕获并积聚在绝缘体表面,因此可能会产生电荷。
在大块绝缘材料的电子显微分析中,由于初级电子在失去动能后被捕获并积聚在绝缘体表面,因此可能会产生电荷。[1] 绝缘体的充电取决于其材料特性,包括电阻率、化学键、杂质、固有缺陷和抗辐射性。通常,绝缘子必须涂上导电材料,以便通过常规SEM进行观察和分析。但是,如果微量元素与涂层材料中所含的元素相同,或者涂层导致所分析的材料(如有机化合物)损坏,则在分析微量元素时可能会出现问题。[2,3]开发了环境扫描电子显微镜(ESEM),用于在受控压力下直接观察气体中的绝缘体,而不是导电层。[4,5]控制ESEM中10–200 Pa的环境气体,以创建中和过程并避免样品表面上的电荷。由于气体压力太高,无法使用常规闪烁体光电倍增管探测器(如Everhart–Thornley(ET)探测器)成像,因此需要一个由多个压力级和气体二次电子(SE)探测器组成的真空系统。通过使用辅助泛光枪中和、辐照表面上的正偏压、加热样品等,可以减少或避免绝缘子上的电荷。[6]郭等人利用环境俄歇电子能谱(AES)研究了一些氧化物陶瓷的充电效应和补偿,例如Al2O3、SiO2、ZrO2和YS-ZrO2。
在氧气环境下,用扫描电子显微镜(SEM)研究了氧化物的电荷现象和电荷补偿。在2.9*10-3和2* 10-2 Pa之间的O2压力下,带有Cu条纹的非晶SiO2和多晶Al2O3的电荷减少。氧化物的电荷效应和电荷补偿可能是由于一次电子轰击下表面阴离子空位的形成和氧气氛下氧离子的补充。Al2O3的俄歇电子能谱(AES)证明,在压力降至5*10-6 Pa的O2环境中,Al2O3的充电效应得到完全补偿。以下为Al2O3样品的充电现象和补偿图。
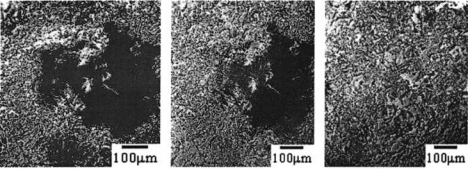
图一 Al2O3样品的充电现象和补偿:(a)在压力为2.0*10-3 Pa的常规SEM中获得视图,(b)和(c)在压力为6.2*10-3和8.4*10-3 Pa的O2环境SEM中获得视图
参考文献
1.Reimer, L. Scanning Electron Microscopy; Optical Sciences; Springer-Verlag: Berlin, Germany, 1995; 117–125.
2.Hayakawa, S.; Kagoshima, Y.; Tsusaka, Y.; Matsui, J.; Hirokawa, T. High resolution X-ray fluorescence measurements using a flat analyzer crystal and an X-ray CCD. J. Trace Microprobe Techn. 2001, 19, 615–621.
3.Younan, H. Studies on quantification of analysis of thin film layers (Si3N4, SiO2 and TiW) in water fabrication using energy-dispersive X-ray microanalysis technique and sec factors. J. Trace Microprobe Techn. 2003, 21, 25–34.
4.Danilatos, G.B. Design and construction of an atmospheric or environmental SEM. Micron Microsc. Acta. 1985, 14, 307–319.
5.Oebbeke, I. New possibilities of material analysis and evaluation by ESEMEnvironmental scanning electron microscope. Metallogr. 1998, 35 (2), 61–70.
6.Kanaya, K.; Ichise, N.; Adachi, K. Observation on charging effects of non-conductive and uncoated materials by ion beam pre-bombardment in SEM. Micron Microsc. Acta. 1992, 23, 319–325.











 您已经拒绝加入团体
您已经拒绝加入团体

 2022-02-18
2022-02-18
 5124
5124
 0
0










