【摘要】 在半导体、微电子等电路制造工艺中,对薄膜的厚度和光学常数进行准确的测定是非常重要的一步,在已经知道薄膜的光学常数的前提下,则仅需要测试薄膜厚度,测定方法包括电解法等非光学方法和X射线法、干涉法以及椭偏法等光学方法。
在半导体、微电子等电路制造工艺中,对薄膜的厚度和光学常数进行准确的测定是非常重要的一步,在已经知道薄膜的光学常数的前提下,则仅需要测试薄膜厚度,测定方法包括电解法等非光学方法和X射线法、干涉法以及椭偏法等光学方法。电解法在测试时易损伤样品,且适用范围多局限在金属薄膜上,X射线法和干涉法不适合测量多层复合薄膜,椭偏法有效的避免了前边几种方法的局限性,其不会损坏样品,测试范围广,且可以同时测量光学常数和薄膜厚度。工业中应用的薄膜既有单层膜又有多层膜,厚度很小,因此椭偏仪的测试研究非常重要[1]。
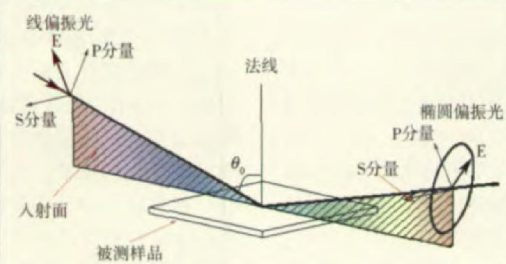
图1. 椭偏仪的基本光学物理结构
椭偏仪测试样品性能指数时通过样品反射或者透射光线偏振状态的变化来完成的,测量光经过样品表面时偏振态的变化如图1所示,偏振光到达样品表面时发生反射,出射光的偏振态发生变化,通过测量这种变化,可计算出样品的性能参数。
 ..........................式1
..........................式1
式1中,tan Y为光p分量反射系数和s分量复反射系数的比值, D代表光p分量和s分量的相对相位变化,椭偏参量Y和D描述了探测光束的偏振变化,Rp代表偏振光相对于入射面的平行分量的反射系数,Rs代表其垂直分量的反射系数。在得到各层薄膜的折射率、膜层厚度和消光系数等参数后即可计算得到r值。
[1] 杨坤; 王向朝; 步扬, 椭偏仪的研究进展[J], 激光与光电子学进展. 2007,(03)











 您已经拒绝加入团体
您已经拒绝加入团体

 2023-04-10
2023-04-10
 12698
12698
 1
1










