【摘要】 目前在元素掺杂领域,对于体相的掺杂量很难进行分析,且分析手段有限,我们所熟知的XPS,可以通过刻蚀不同的深度进行刨析体相掺杂浓度的含量。
介绍
目前在元素掺杂领域,对于体相的掺杂量很难进行分析,且分析手段有限,我们所熟知的XPS,可以通过刻蚀不同的深度进行刨析体相掺杂浓度的含量。
为了进一步研究体相内掺杂掺杂浓度的变化,我们在这里介绍SIMS技术应用于表征掺杂浓度的近似含量。
SIMS的原理
是一种表面分析技术,基于一次离子于样品表面的相互作用。其原理是带有几千电子伏的能量的一次离子束入射样品表面。
在做作用区域发出不同粒子,包括二次电子,中性微粒、二次离子、反射离子等,如下图1所示,通过不同探测器采集不同微粒可得到不同信息,收集二次离子通过质量分析器后可得到样品表面成分信息的质谱,即为二次离子质谱。

图1 SIMS的原理
SIMS的分类
动态的SIMS:入射电流高(10 mA/cm2),入射源离子浓度是大于1014atoms/cm。对表面动态破坏作用(剥离速率100 um/h),产生二次离子比率高,检测灵敏度高,适合深度刨析。
静态的SIMS:入射电流低(1 nA/cm2),入射源离子浓度是大于1012-1013atoms/cm。只作用(剥离速率0.1 nm/h),几乎对表面没有破坏。
因脉冲模式分析,且电流小,产生二次离子比率低,灵敏度于动态的低。但成像和表面分析能力强。
飞行时间二次离子质谱仪(TOF-SIMS)的原理
使用一次脉冲离子轰击固体样品表面,通过表面激发出二次离子的飞行时间测量其质量,以表征表面的元素组成、分子结构、分子键链等信息,如图2所示。
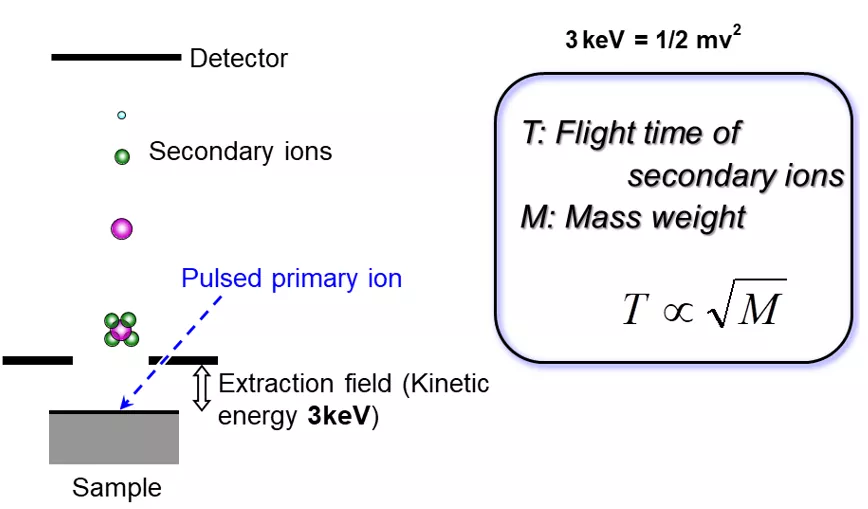
图2 TOF-SIMS的原理
注:优异TOF-SIMS的原理是基于二次离子飞行的时间来展现二次离子的信息,因此,每次的初始离子源入射表面都应在在同一个起点,避免距离不同而导致的错误分析,因此只能使用脉冲模式,而不能使用动态模式。
TOF-SIMS的表面分析能力及特点

参考:
www.360doc.com
本文所有内容文字、图片和音视频资料,版权均属科学指南针网站所有,任何媒体、网站或个人未经本网协议授权不得以链接、转贴、截图等任何方式转载。











 您已经拒绝加入团体
您已经拒绝加入团体

 2021-11-17
2021-11-17
 11003
11003
 0
0










