【摘要】 科学指南针-高端测试2021年末限时优惠活动,活动日期:2021.12.15-2021.12.31
科学指南针-高端测试2021年末限时优惠活动
活动日期:2021.12.15-2021.12.31
一、FIB/原位SEM/EBSD,85折(领券下单)
1. 聚焦离子束扫描电镜(FIB-SEM)
2. 原位(拉伸)扫描电子显微镜(in-situ-SEM)
3. 原位(拉伸)EBSD(in-situ-EBSD)

二、Micro/Nano/工业CT,满3000元减500元

三、球差校正透射电子显微镜(AC-STEM/TEM),全网最低价2200/h起
测试扫码咨询

科学指南针高端测试-官方二维码
聚焦离子束显微镜(FIB)原理以及应用简介
新世纪以来,纳米科技作为新出生的一个领域已猛然成为国家科技创新的主要板块,作为国家战略的纳米科技对经济和社会发展有着重要的意义。研发性质优良的新型功能器件材料需要发展精度高的加工技术。
由此,聚焦离子束切割系统(FIB)应运而生,并且越来越广泛地应用于不同领域的微观材料观察,成为块体以及器件加工领域不可或缺的存在。
原理篇
聚焦离子束显微镜(FIB) 就是将离子束与SEM相结合,利用电子透镜将离子束聚焦成非常小尺寸的精细切割技术,如图所示,其主要由离子发射源、离子光学柱、束描画系统、信号采集系统和样品台这五部分组成。离子束是FIB系统的核心,所采用的是液态金属离子源(LMIS),其中镓(Ga)离子源由于其低熔点,低蒸汽压以及良好的稳定性等广受应用。
一般双束设备是电子束垂直于水平面安装,离子束与电子束形成一个夹角。在使用过程中样品处于共心高度的位置(通常称电子束和离子束焦平面的交点为共心高度位置)即可同时实现离子束加工和电子束成像功能,并可以通过样品台的倾转实现电子束或离子束与样品表面垂直。
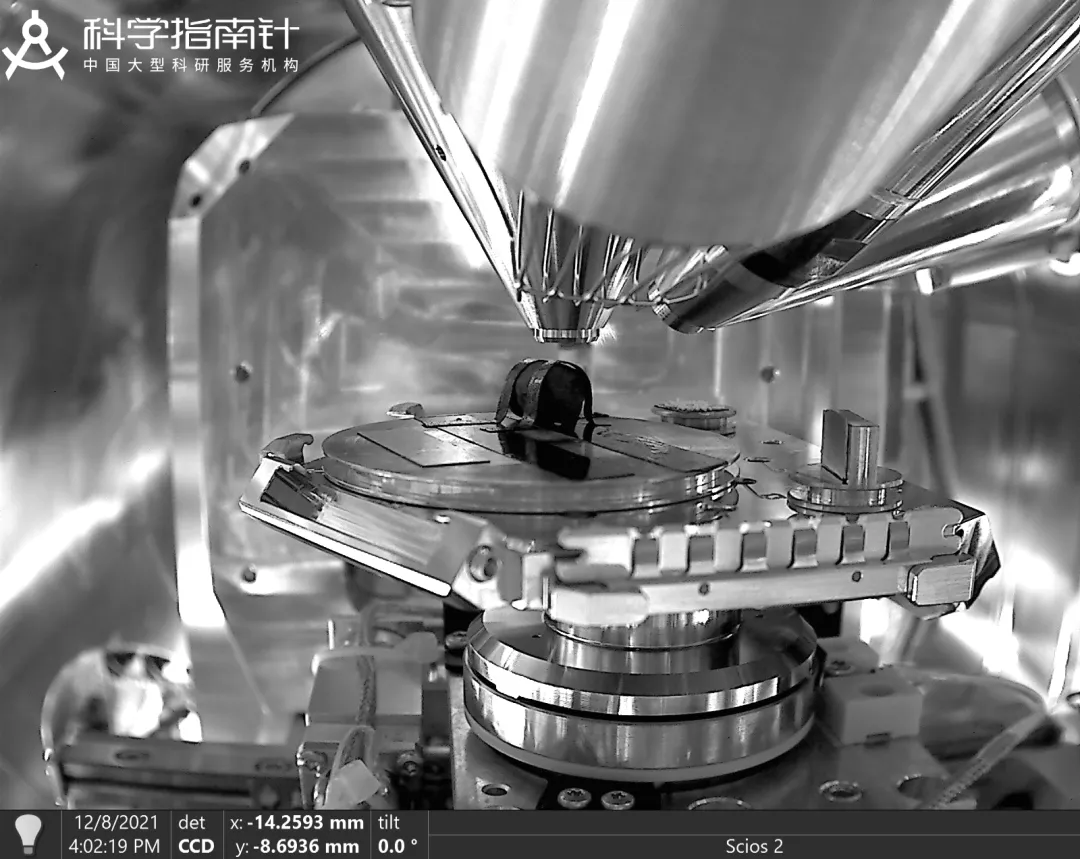
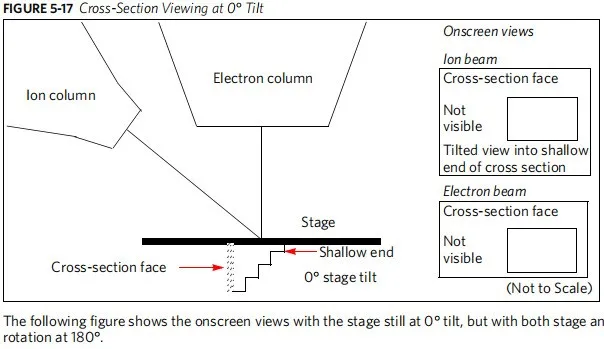
常见聚焦离子束系统为两级透镜系统。液态金属离子源产生的离子束,在外加电场的作用下,形成一个极小的尖端,再加上负电场牵引尖端的金属,从而导出离子束。
-
首先,在通过第一级光阑之后,离子束被第一级静电透镜聚焦,初级八级偏转器用于调整离子束以减小像散。经过一系列的可变化孔径,可灵活改变离子束束斑的大小。
-
其次,次级八极偏转器使离子束根据被定义的加工图形进行扫描加工,通过消隐偏转器和消隐阻挡膜孔可实现离子束的消隐。
-
最后,通过第二级静电透镜,离子束被聚焦到非常精细的束斑,分辨率可至约5nm。被聚焦的离子束轰击在样品表面,产生的二次电子和离子被对应的探测器收集并成像。
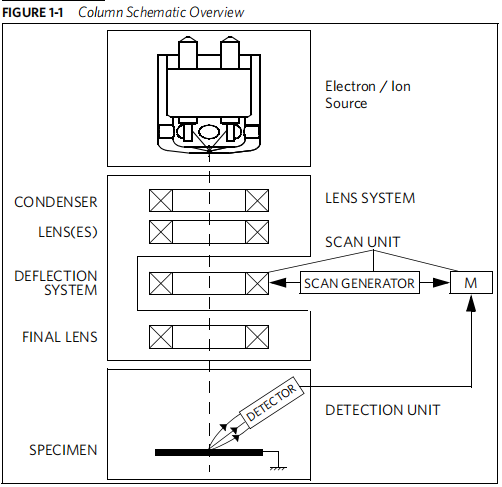
应用篇
目前,聚焦离子束显微镜(FIB)常用的部分应用有如下几种:
一、TEM制样
由于块体样品无法直接拍摄TEM,故需要特殊制样后才能上机,常见需要FIB制样的材料有金属块体、岩石、陶瓷,宝石、半导体材料,基底负载的二维材料以及电池材料等。FIB制备TEM样品的优点主要有以下几点:
1.能满足在特殊形貌或者物相处取样
2.减薄厚度可控,制样成功率非常高
3.薄区相对于其他块体制样方法而言会更大,保证拍摄区域的大小,下面采用图片简述FIB制备TEM样品的过程以及展示几类采用FIB制样得到的样品图:
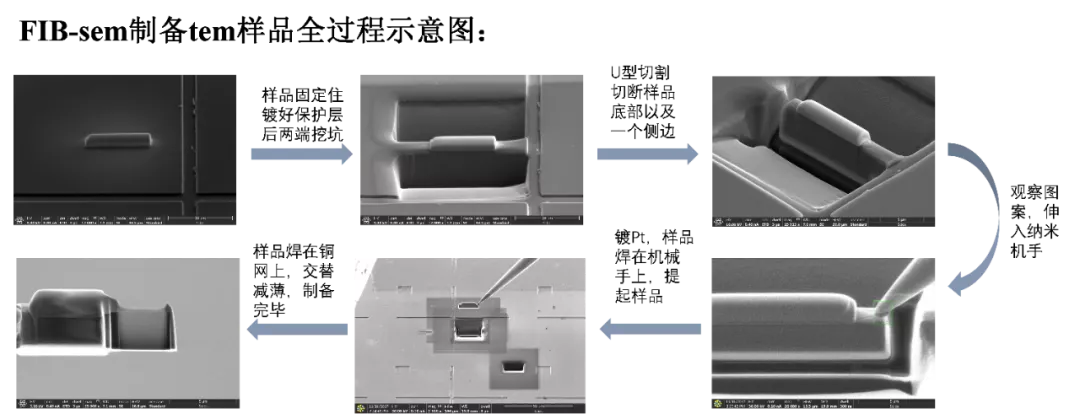
样品示例展示:
-
电池材料 电池材料多数为微米级别的颗粒,不能直接拍TEM,需要切成薄片后拍摄TEM,如果是锂电池材料,原子序数较小,pt进入材料后,TEM下会比较明显,尤其是暗场图,一般切片前沉积一层C保护层。

-
金属材料 金属材料比较多的是大的块体,如不需要定位可选择离子减薄制样,定位的就得选用FIB-SEM制样了,断口样品要能挑选到表面平整位置制样。
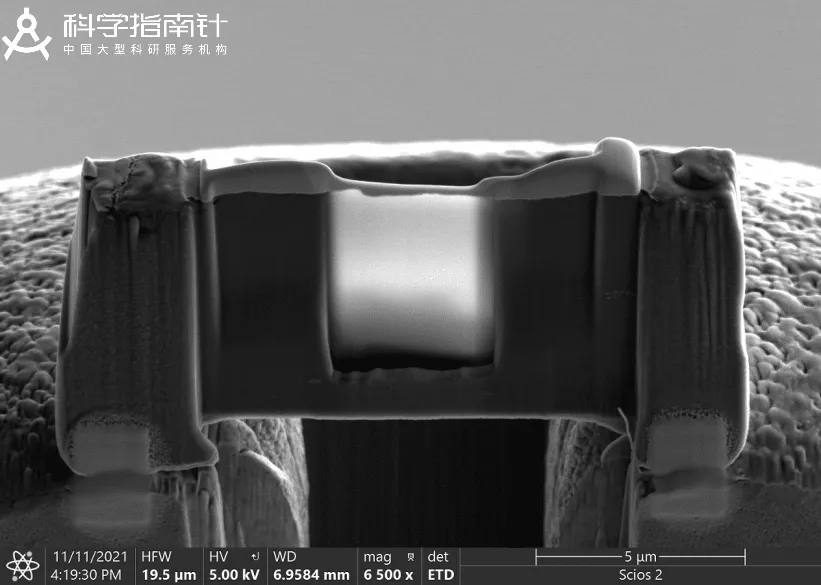
-
带衬底薄膜材料 常见的是看单层或多层膜分层厚度以及所含元素成分。遇到表面膜层比较薄的,一般用电子束层积一层C保护层,尽可能减少保护层对表层的影响。

二、剖面分析
利用FIB可以对样品进行精准切割,制备出样品的截面,并通过SEM对所制备的截面精修微观表征,同时可以结合能谱点扫,面扫,线扫等对截面成分进一步的分析。该测试技术在电池材料,芯片领域以及半导体材料得到广泛应用。


三、微纳加工
FIB系统由于其精准切割功能,可以直接对材料进行微纳加工,常见的光纤刻线以及金属微区溅射等都能实现。另外FIB还可用于制备微柱压缩需要的圆柱以及三维原子探针测试所需的针尖样品。
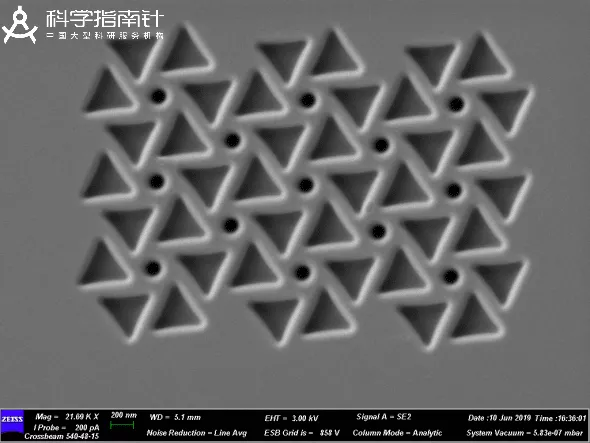
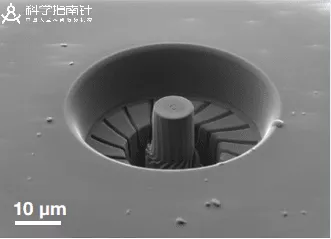

四、三维重构
使用FIB对材料进行三维重构的可得到材料内部微小成分的分布等信息,这种表征手段多用于材料类、岩石类以及各种功能材料等。FIB三维重构其过程就是仪器控制FIB进行逐层切割,得到的每小片材料用SEM进行拍摄,两者交替进行。最后再将得到的数据导入重构软件进行分析得到材料的三维图。

五、器件失效分析
对于常见的半导体材料而言,由于目前集成电路的发展,现在电路的线宽越来越窄,电路越来越复杂,这对于材料的失效位点以及其具体修复提出了更高的要求。FIB利用其精准切割跟定点沉积的功能,在半导体器件失效分析这块大放异彩。

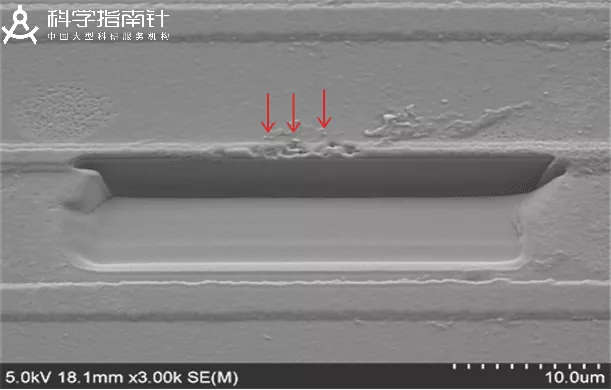
六、科学指南针南京实验室自营FIB-SEM;HRTEM,欢迎您现场测试。


七、更多高端测试。

本文所有内容文字、图片和音视频资料,版权均属科学指南针网站所有,任何媒体、网站或个人未经本网协议授权不得以链接、转贴、截图等任何方式转载。











 您已经拒绝加入团体
您已经拒绝加入团体

 2022-01-06
2022-01-06
 15108
15108
 1
1










